☆ ナノインプリント・リソグラフィ(NIL)のためのフィルム・モールド材料
現在、半導体の製造において、フォトリソグラフィでのパターンの形成が主流となっていますが、パターンの微細化に伴い装置が高額になっていることからナノインプリント・リソグラフィ(NIL) が注目されつつあります。既に、BEOL(Back end of line) の形成、高輝度LED の製造、磁気媒体へのパターン形成などにNILが利用されています。NIL では、スタンプをすることが基本になっているため装置は比較的廉価なのですが、モールドを製作するための時間とコストがかかります。通常、オリジナルのモールドは、そのまま利用せず、オリジナルからレプリカ モールドを作成し、それを利用します。レプリカモールドには、フィルム・モールドが利用されることが多いですが、その材料には次のような厳しい特性が求められることから、適切な材料の開発が急務となっています。
① 正確で微細パターンが形成されること
② 機械的な圧力を受けても変形しないこと
③ 収縮しないこと
④ 熱NILプロセスの場合には高温に耐えること
⑤ UV(紫外線)NILプロセスの場合には紫外線を透過すること
⑥ 離型が容易なこと(低表面エネルギーであること)
フィルム・モールド材として検討されているものにPDMS、テフロン、ポリウレタン、PFPE などの柔らかい有機或いは高分子材料がありますが、100nm 以下のパターンでは大きさが不安定になる、機械的な圧力に弱く変形してしまう、また、紫外線を透過しないなどの問題がありました。
弊社の開発したシルセスキオキサンは、 Si-Oを骨格にしたnm サイズの立体構造をした有機・無機のハイブリッド材料であり、①熱NILプロセスで正確な微細パターンが容易に形成できる ②高弾性の構造をしており収縮が殆どない ③高温安定性 ④水晶のように紫外線を透過する ⑤低表面エネルギー などの特性があります。このことから正にフィルム・モールド材に適切な材料と言えます。
図1.フィルム・モールド材として最適な3つのシルセスキオキサン (a) オクタジメチルシロクシ・オクタシルセスキオキサン (OTSE) (b) テトラジメチル・シロクシ・オクタシルセスキオキサン (TTSE) (c) テトラ2-ハイドロクシエソクシ・エチル・ジメチルシロクシ・オクタシルセスキオキサン (TOETSE)
米国国立標準技術研究所(NIST)の支援を受けて、シスセスキオキサンの1つであるテトラジメチル–シロキシ–オクタシルセスキオキサン(TTSE)を利用し、SiO2 のマザーモールドから TTSE のフィルム・モールドを作成し、それからポリスチレン(PS)インプリントを行う実験を行いました。TTSE は図1-(b) に示されるようにシルセスキオキサンの基本構造をベースに Si(OEt)3 と Si-Hを各々4つ持っており、次の特性を有しています。
① 弾性係数:~ 5GPa
② 低い熱膨張係数(CTE): ~ 25E-6 /℃ (これは SiOx に匹敵する係数です)
③ 水晶のようなUV透過性
④ 高疎水性:接触角 ~100°(離型に優れている)
これらは全てフィルム・モールド材に必要な特性となっています。
<実験の内容>
① SiO2 で製作されたマザーモールドから熱NILプロセスでTTSEのレプリカ フィルム・モールド(子モールド)を作成しました。
② この子モールドを利用して高温・高圧の下でポリスチレン(PS)インプリントを行いました。
これらのパターンを鏡面反射X線装置(SXR)及びX線散乱装置(CD-SAXS) を利用して観察しました。その結果を図2に示します。
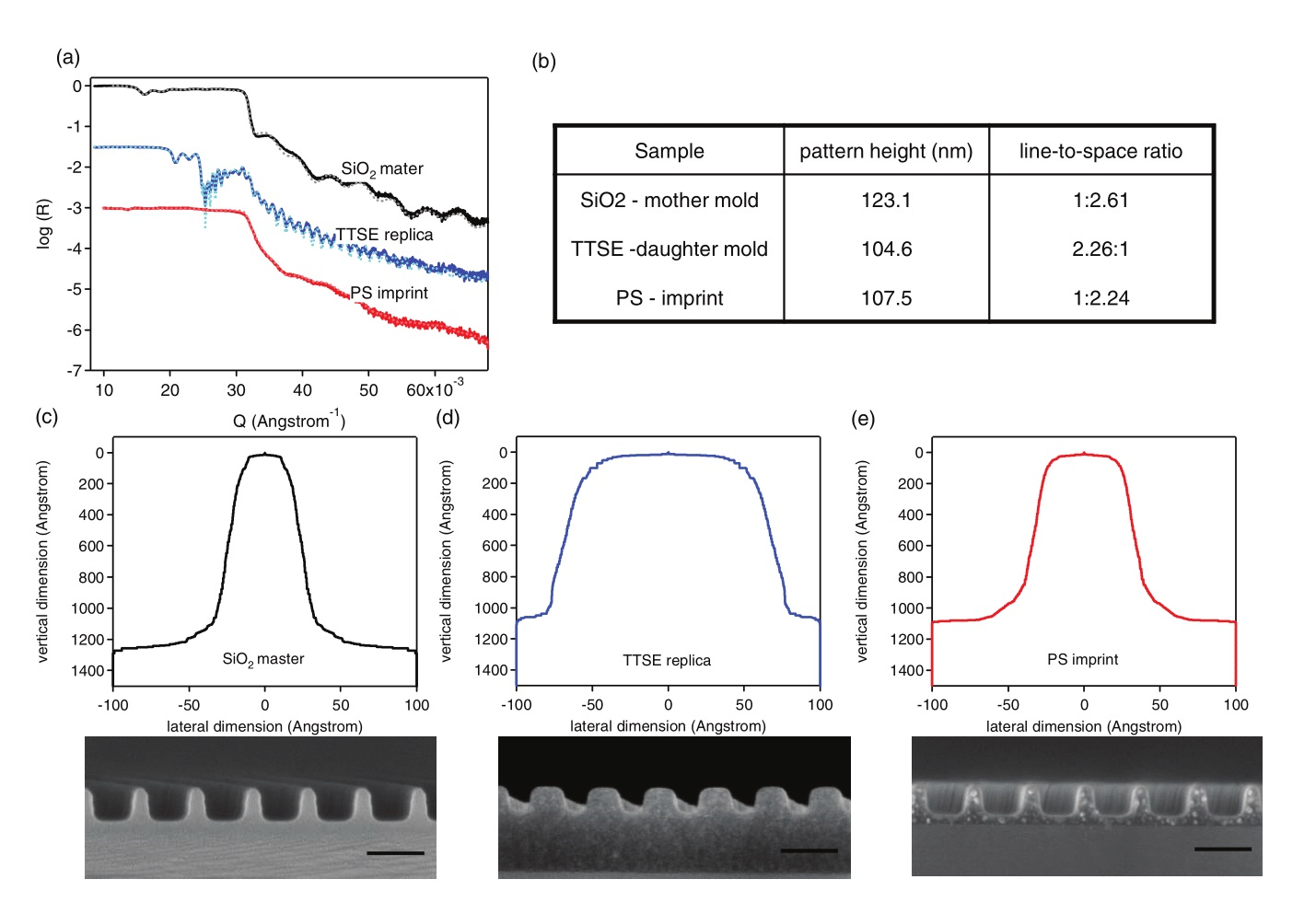 図2.(a) SXR で観察された曲線。SiO2マザーモールド、TTSE レプリカモールド及びPSインプリントの密着結果が示されている。 (b) SXRで観察されたSiO2マザーモールド、TTSE レプリカモールド及びPSインプリントのパターンの高さ及び山と谷の比率 (c) SXR の密着結果から導かれたSiO2マザーモールド、TTSE レプリカモールド及びPSインプリントの断面パターンの形状。その下は、走査電子顕微鏡(FE-SEM)で観察した断面写真。
図2.(a) SXR で観察された曲線。SiO2マザーモールド、TTSE レプリカモールド及びPSインプリントの密着結果が示されている。 (b) SXRで観察されたSiO2マザーモールド、TTSE レプリカモールド及びPSインプリントのパターンの高さ及び山と谷の比率 (c) SXR の密着結果から導かれたSiO2マザーモールド、TTSE レプリカモールド及びPSインプリントの断面パターンの形状。その下は、走査電子顕微鏡(FE-SEM)で観察した断面写真。
③ 更に、TTSE レプリカ フィルム・モールドで直接PSフォルムに高温・高圧下でインプリントを行う実験 及び UV NIL プロセスでのUV透過実験も実施し、すばらしい結果となりました。
<まとめ>
TTSE 及びその他の関連するシルセスキオキサンは、今後、NIL 発展のためのレプリカ フィルム・モールド材として有望であることが示されました。
今回の詳細な技術資料(英文)は、NIL技術資料 (ENG) からダウンロードすることができます。



